A new technical paper, “Source-position-dependent transmission cross coefficient formula including polarization and mask three-dimensional effects in high-numerical-aperture extreme ultraviolet lithography” was published by researchers at Institute of Science Tokyo. This work is based on the paper presented at SPIE Advanced Lithography + Patterning 2026.
“The polarization effect is not negligible in high-NA EUV lithography. The purpose of this work is to extend the STCC* formula to include the polarization effect and enable accurate and fast simulation of polarization-dependent imaging in high-NA EUV lithography,” states the paper.
Find the technical paper here. May 2026.
Journal of Micro/Nanopatterning, Materials, and Metrology, Vol. 25, Issue 3, 031604 (May 2026). https://doi.org/10.1117/1.JMM.25.3.031604
Authors: Hiroyoshi Tanabe, Moe Sugiyama, Masayuki Shimoda, Atsushi Takahashi
*STCC=source-position-dependent transmission cross coefficient

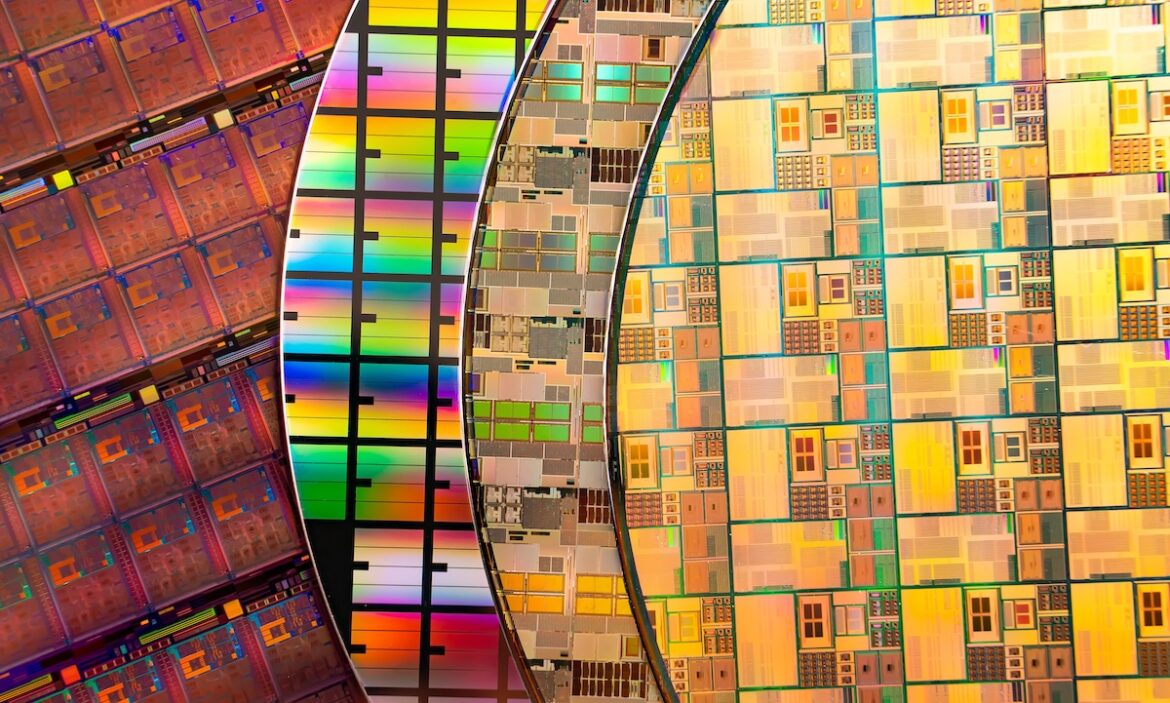
AloJapan.com