A new technical paper titled “Hybrid surface pre-treatments for enhancing copper-to-copper direct bonding” was published by researchers at National Chung Hsing University (NCHU) and Osaka University.
Abstract excerpt
“Three-dimensional integrated circuits (3D IC) require low-temperature, high-reliability Cu–Cu direct bonding to support fine-pitch vertical interconnects and heterogeneous integration. This study developed a hybrid surface pretreatment method combining plasmas and pulsed high-energy flash irradiations to modify Cu surface conditions and enhance bonding performance.”
Find the technical paper here. January 2026.
Chen, Wei-Ting, Liang-Hsing Shih, Kiyokazu Yasuda, and Jenn-Ming Song. “Hybrid surface pre-treatments for enhancing copper-to-copper direct bonding.” Materials & Design (2026): 115554.
Creative Commons license.

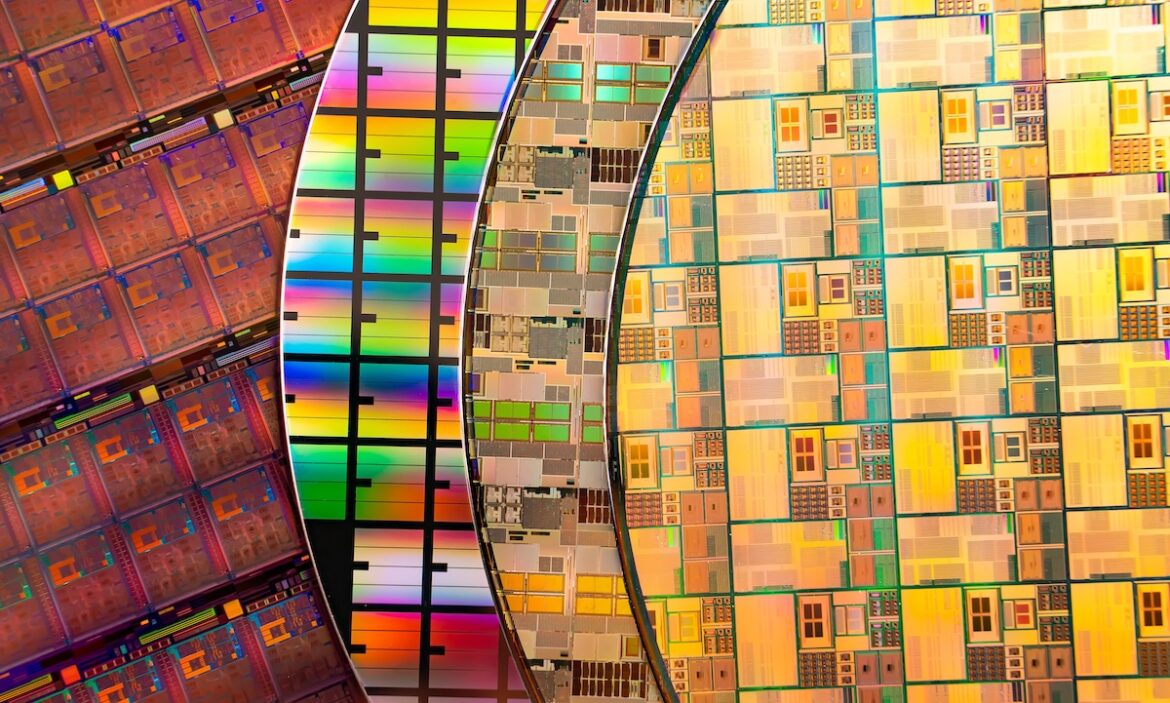
AloJapan.com